иғҪеҲӣе»әPCBе°ҒиЈ…еә“дёҺдјҡжӯЈзЎ®ең°еҲӣе»әPCBе°ҒиЈ…еә“жҳҜ2дёӘе®Ңе…ЁдёҚеҗҢзҡ„жҰӮеҝөпјҢиғҪеҲӣе»әеә“еҸҜиғҪеҸӘжҳҜдјҡиҪҜ件ж“ҚдҪңпјҢиҖҢдјҡжӯЈзЎ®ең°еҲӣе»әе°ҒиЈ…еә“еҲҷйңҖиҰҒиҖғиҷ‘еҸҜеҠ е·ҘжҖ§гҖҒз”өгҖҒзғӯзӯүж–№йқўзҡ„зҹҘиҜҶпјҢеӣ дёәеңЁеҲӣе»әе°ҒиЈ…еә“ж—¶йңҖиҰҒеҜ№з„Ҡзӣҳе°әеҜёж•°жҚ®иЎҘеҒҝгҖӮжІЎз»Ҹз„ҠзӣҳиЎҘеҒҝеӨ„зҗҶзҡ„PCBе°ҒиЈ…еә“еҫҲеӨҡж—¶еҖҷзңӢжқҘиө·жӯЈзЎ®пјҢдҪҶжҳҜиҝӣе…ҘеҗҺеәҸйҮҸдә§йҳ¶ж®өдјҡеј•иө·иҝһй”ЎгҖҒз«Ӣзў‘зӯүеҗ„з§Қй—®йўҳпјҢе…¶дёӯз”ҹдә§дёӯйҒҮеҲ°зҡ„“з«Ӣзў‘”зҺ°иұЎдёӯзҡ„йҮҚиҰҒеҺҹеӣ д№ӢдёҖе°ұжҳҜеӣ дёәе°ҒиЈ…зҡ„з„Ҡзӣҳеә“иЎҘеҒҝеҸӮж•°дёҚжӯЈзЎ®гҖӮ
“з«Ӣзў‘”иҝҷиҜҚжңүзӮ№зҳҶдәәпјҢе…·дҪ“зҡ„иҝҮзЁӢеҰӮдёӢйқўзҡ„еҠЁжҖҒе°Ҹи§Ҷйў‘пјҡ

еӣҫ 1. з«Ӣзў‘еҸ‘з”ҹиҝҮзЁӢ
з”ұдәҺ移еҠЁзұ»дә§е“ҒеңЁе°ҸеһӢеҢ–гҖҒиҪ»дҫҝж–№йқўзҡ„ејәзғҲйңҖжұӮпјҢдҝғдҪҝе…¶жүҖз”Ёзҡ„з”өеӯҗе…ғ件и¶ҠжқҘи¶Ҡе°ҸпјҲеҰӮпјҡ0402гҖҒ0201гҖҒ01005зӯүиҝҷдәӣйқһеёёе°Ҹзҡ„зүҮејҸеҲҶз«Ӣе…ғ件пјүпјҢеҠ дёҠзҺҜдҝқж–№йқўзҡ„йҷҗеҲ¶пјҢеңЁSMTе·ҘиүәдёӯдҪҝз”Ёж— й“…е·ҘиүәжҠҖжңҜеҗҺпјҢдјҡдҪҝж— й“…й”ЎиҶҸзҡ„жөёж¶ҰжҖ§еҸҳе·®пјҢиҝҷдәӣе°Ҹе…ғ件еңЁеҠ е·Ҙзҡ„иҝҮзЁӢзЁҚжңүдёҚж…Һе°ұжңү“з«Ӣзў‘”зҺ°иұЎзҡ„еҸ‘з”ҹпјҢеҪ“然еҜјиҮҙ“з«Ӣзў‘”з«Ӣзў‘зҡ„еҺҹеӣ йқһеёёеӨҡпјҢдёӢйқўдјҡд»ҺеӨҡж–№йқўиҝӣиЎҢиҜҰз»Ҷзҡ„иҜҙжҳҺпјҢдҪҶдёҚеҸҜеҗҰи®Өзҡ„жҳҜз”ұPCBе°ҒиЈ…еә“е»әеә“зҡ„дёҚжӯЈзЎ®жҖ§жүҖеј•иө·зҡ„жғ…еҶөе°ұжҳҜе…¶дёӯйҮҚиҰҒеҺҹеӣ д№ӢдёҖгҖӮдҪңдёәдёҖдёӘйқһе·Ҙиүәдё“дёҡзұ»зҡ„硬件е·ҘзЁӢеёҲжҲ–PCBе·ҘзЁӢеёҲпјҢеҰӮиҮӘиЎҢе»әPCBе°ҒиЈ…ж—¶еҸӮиҖғгҖҠPCBе°ҒиЈ…дёҺеҺҹзҗҶеӣҫеә“е·ҘзЁӢи®ҫи®ЎгҖӢдёҖд№ҰдёӯжҸҗдҫӣзҡ„е·ҘзЁӢж•°жҚ®пјҲиҝҷдәӣе·ҘзЁӢж•°жҚ®йғҪе·Із»ҸиҝҮдәҶеҚ•жқҝйӘҢиҜҒпјүпјҢиҮіе°‘еҸҜд»ҘеңЁPCBе»әеә“зҡ„ж—¶е°ұиғҪжҠҠдёҖдәӣжҳҺжҳҫзҡ„й”ҷиҜҜжҺ’йҷӨжҺүгҖӮ
2.1 еҸ—еҠӣзӨәж„Ҹ
з«Ӣзў‘дё»иҰҒеҺҹеӣ жҳҜз”ұдәҺеңЁеӣһжөҒж—¶е…ғеҷЁд»¶зҡ„дёӨз«ҜеңЁзҶ”и§Јзҡ„з„Ҡж–ҷдёӯеҸ—еҲ°зҡ„еј еҠӣдёҚе№іиЎЎгҖӮеӣһжөҒз„ҠиҝҮзЁӢдёӯе…ғ件主иҰҒеҸ—еҠӣеҰӮдёӢеӣҫжүҖзӨәпјҡ
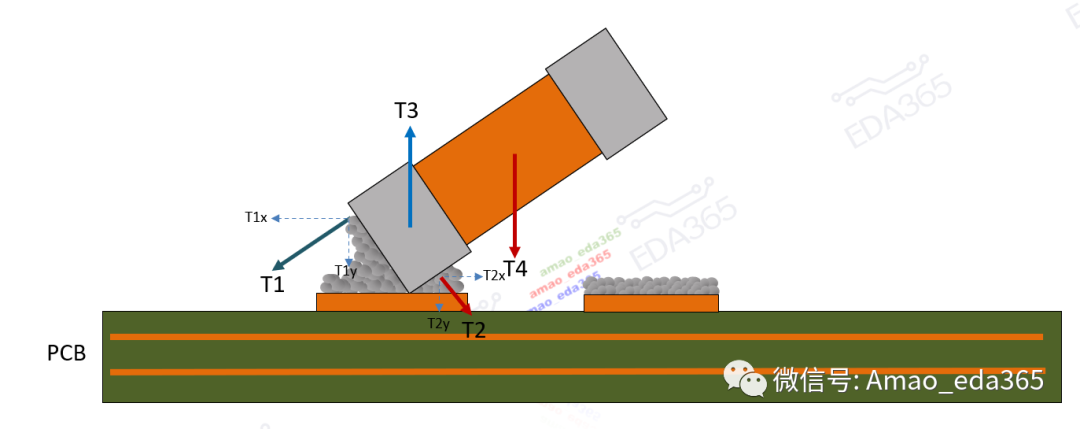
еӣҫ 2. е…ғ件SMTеҸ—еҠӣзӨәж„Ҹ
дё»иҰҒжңүдёӢйқўзҡ„еӣӣз§ҚеҠӣж–ҪеҠ еңЁе…ғ件дёҠпјҡ
пјҲ1пјүT1:з„ҠзӣҳеӨ–дҫ§solderжӢүеҠӣ
пјҲ2пјүT2:з„ҠзӣҳеҶ…дҫ§solderжӢүеҠӣ
пјҲ3пјүT3: solderжө®еҠӣ
пјҲ4пјүT4:е…ғ件йҮҚеҠӣ
еҪ“T1еҫҖеӨ–зҡ„жӢүеҠӣеӨ§дәҺе…¶дҪҷеҗ„еҠӣзҡ„еҗҲеҠӣж—¶пјҢе°ұеҸ‘з”ҹдәҶз«Ӣзў‘гҖӮ
2.2 еҺҹеӣ еҲҶжһҗ
еҶҚж·ұе…ҘеҲҶжһҗ“з«Ӣзў‘”еҸ‘з”ҹзҡ„еҺҹеӣ пјҢжңҖз»ҲеҪ’зәідёәдёӢйқўиҝҷеҮ ж–№йқўпјҡ
1гҖҒ з„ҠзӣҳеӨ§е°Ҹ
еңЁи®ҫи®Ўз„Ҡзӣҳж—¶еҰӮз„Ҡзӣҳи¶…иҝҮе…ғ件з«ҜеӯҗеҗҺеҗ‘еӨ–иЎҘеҒҝе°әеҜёеӨӘе°‘е°ҶдјҡеҮҸе°‘жңүж•Ҳи§’пјҢд»ҺиҖҢеңЁз„ҠзјқйқўдёҠеўһеҠ жӢүеҠӣзҡ„еһӮзӣҙзҹўйҮҸпјҢдҪҝз«Ӣзў‘зҺ°иұЎжӣҙеҠ дёҘйҮҚгҖӮеҰӮжһңз„ҠжҺҘз„Ҡзӣҳи®ҫи®ЎеӨӘе®ҪпјҢе…ғ件еҲҷдјҡжјӮ移иҖҢдҪҝе…ғ件дёӨз«Ҝд№Ӣй—ҙзҡ„жӢүеҠӣеӨұеҺ»е№іиЎЎеӣ жӯӨдә§з”ҹдәҶз«Ӣзў‘гҖӮ
гҖҗи§ЈеҶіж–№ејҸгҖ‘
е·ҘзЁӢз»ҸйӘҢеҸ‘зҺ°пјҢеҮҸе°‘з„Ҡзӣҳзҡ„е®ҪеәҰеҸҠйҖӮеҪ“еўһеҠ еҗ‘еӨ–延伸й•ҝеәҰпјҢеҰӮжқЎд»¶е…Ғи®ёпјҢдҪҝз”ЁеңҶзҠ¶з„ҠзӣҳжҜ”иө·зҹ©еҪўжҲ–жӯЈж–№еҪўз„ҠзӣҳжҸҗдҫӣжӣҙдҪҺзҡ„з«Ӣзў‘зҺҮгҖӮ
иҖҢгҖҠPCBе°ҒиЈ…дёҺеҺҹзҗҶеӣҫеә“е·ҘзЁӢи®ҫи®ЎгҖӢдёҖд№ҰдёӯеҜ№дәҺдёҚеҗҢе°ҒиЈ…зҡ„дёҚеҗҢз„ҠзӣҳеңЁи®ҫи®Ўж—¶жҸҗдҫӣдәҶз„ҠзӣҳиЎҘеҒҝзҡ„ж•°жҚ®пјҢиҝҷдәӣз»ҸиҝҮз”ҹдә§йӘҢиҜҒзҡ„е·ҘзЁӢж•°жҚ®пјҢеҸҜд»ҘдҪңдёәеӨ§еӨҡж•°зҡ„硬件жҲ–PCBе°ҒиЈ…и®ҫи®Ўе·ҘзЁӢеёҲиҮӘиЎҢе»әеә“ж—¶зҡ„еҸӮиҖғгҖӮ

еӣҫ 3. ж•°жҚ®ж‘ҳиҮӘгҖҠPCBе°ҒиЈ…дёҺеҺҹзҗҶеӣҫеә“е·ҘзЁӢи®ҫи®ЎгҖӢ
2гҖҒз„Ҡзӣҳй—ҙйҡ”е°әеҜёи®ҫи®Ў
зүҮејҸе…ғ件дёӨз„Ҡзӣҳд№Ӣй—ҙй—ҙйҡ”еҰӮи®ҫи®ЎдёҚеҗҲзҗҶд№ҹдјҡдә§з”ҹз«Ӣзў‘пјҢеӨӘе°Ҹзҡ„й—ҙйҡ”е°Ҷеј•иө·зүҮејҸе…ғ件жң¬иә«еңЁзҶ”иһҚз„Ҡж–ҷдёҠйғЁжјӮ移пјҢеӨӘеӨ§зҡ„й—ҙйҡ”е°ҶеҫҲе®№жҳ“йҖ жҲҗдёӨиҖ…д№Ӣдёӯд»»дёҖз«Ҝд»Һз„ҠзӣҳдёҠзҝҳиө·гҖӮ
гҖҗи§ЈеҶіж–№жЎҲгҖ‘
е…ғеҷЁд»¶дёӨз„Ҡзӣҳд№Ӣй—ҙйҮҮз”ЁйҖӮеҪ“зҡ„й—ҙйҡ”пјҢе…·дҪ“еёёз”Ёзҡ„е…ғ件д№ҹеҸҜд»ҘеҸӮиҖғгҖҠPCBе°ҒиЈ…дёҺеҺҹзҗҶеӣҫеә“е·ҘзЁӢи®ҫи®ЎгҖӢд№ҰдёӯжңҖеҗҺзҡ„е®һзү©1:1ж ·дҫӢеә“гҖӮ
*еҰӮеҸӘжҳҜдёәдәҶз®ҖеҚ•ең°еӨ„зҗҶз«Ӣзў‘зҡ„еҪұе“ҚпјҢз„Ҡзӣҳд№Ӣй—ҙзҡ„й—ҙйҡ”йҖҡеёёдјҡйҮҮз”ЁзЁҚзҹӯдәҺзүҮејҸе…ғ件з«Ҝеӯҗзҡ„дёӨдёӘйҮ‘еұһд№Ӣй—ҙзҡ„й—ҙйҡ”гҖӮ
3гҖҒзүҮејҸеҲҶз«Ӣе…ғ件з«Ҝеӯҗзҡ„йҮ‘еұһе°әеҜё
еҰӮжһңзүҮејҸе…ғеҷЁд»¶дёӢйқўзҡ„йҮ‘еұһз«Ҝеӯҗзҡ„е®ҪеәҰе’Ңйқўз§ҜйғҪеӨӘе°ҸпјҢе®ғ们е°ҶеҮҸе°‘зүҮејҸе…ғ件дёӢйқўзҡ„жӢүеҠӣпјҢдјҡеҠ еү§з«Ӣзў‘гҖӮ

еӣҫ 4. е…ғ件з«Ҝеӯҗзҡ„йҮ‘еұһе°әеҜё
гҖҗи§ЈеҶіж–№жЎҲгҖ‘
еңЁйҖүз”ЁзүҮејҸе…ғеҷЁд»¶ж—¶пјҢе°ҪйҮҸйҖүз”ЁиҫғеӨ§зҡ„е®ҪеәҰе’Ңйқўз§Ҝз«Ҝеӯҗзҡ„е…ғ件гҖӮ
д»ҘдёҠжҸҗдҫӣдәҶеёёз”ЁзүҮејҸе…ғ件е»әPCBе°ҒиЈ…еә“ж—¶зҡ„з„ҠзӣҳеҸҠе°ҒиЈ…е°әеҜёж–№йқўзҡ„е·ҘзЁӢж•°жҚ®пјҢд»ҘдёӢеҲҷжҳҜдёҺе…ғ件еҠ е·Ҙзӣёе…ігҖӮ
4гҖҒжё©еәҰжўҜеәҰдјҡеӣ дёҚеқҮеҢҖзҡ„зғӯйҮҸеҲҶеёғжҲ–йҷ„иҝ‘зҡ„е…ғ件йҳҙеҪұж•Ҳеә”иҖҢеўһеҠ
з„ҠзӣҳиҝһжҺҘеҲ°еӨ§зҡ„ж•ЈзғӯеұӮжҲ–й“ңз®”еҸҜиғҪжҜ”е…¶д»–еҜ№еә”з„Ҡзӣҳжё©еәҰиҰҒдҪҺпјҢеҜјиҮҙз«Ӣзў‘гҖӮйҳҙеҪұж•Ҳеә”жҳҜз”ұдәҺеңЁе…ғ件йҷ„иҝ‘еҠ зғӯд»ӢиҙЁжөҒеҠЁеҸ—еҲ°йҳ»ж»һгҖӮ
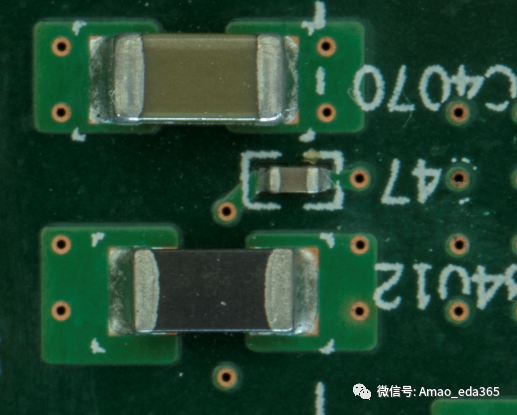
еӣҫ 5. йҳҙеҪұж•Ҳеә”
гҖҗи§ЈеҶіж–№жЎҲгҖ‘
пјҲ1пјүйҖҡиҝҮйҖӮеҪ“зҡ„PCBеёғеұҖжҠҠйҳҙеҪұж•Ҳеә”еҮҸеҲ°жңҖе°ҸгҖӮ
пјҲ2пјүи®ҫи®Ўж—¶дјҳеҢ–з„Ҡзӣҳзҡ„иҝһжҺҘж–№ејҸпјҲеҰӮиЎЁеұӮз„ҠзӣҳдёҺCopperйҮҮз”Ёйқһе…ЁиҝһжҺҘпјүжҲ–дёҺдёҚеҗҢеұӮзҡ„иҝһжҺҘж–№ејҸзӯүдәҺеҮҸе°‘ж•Јзғӯзҡ„дёҚеқҮеҢҖпјҢе°ҶзғӯйҮҸзҡ„дёҚеқҮзӯүеҲҶеёғеҮҸеҲ°жңҖе°ҸпјҢеҢ…жӢ¬з„ҠзӣҳдёҺж•ЈзғӯеұӮзҡ„иҝһжҺҘгҖӮ
пјҲ3пјүеӣһжөҒж—¶дҪҝз”Ёзј“е’Ңзҡ„еҠ зғӯйҖҹзҺҮпјҢйҒҝе…ҚйҮҮз”Ёж°”зӣёеӣһжөҒж–№жі•гҖӮ
пјҲ4пјүеңЁеӣһжөҒеүҚйў„е№ІжҲ–дҪҝз”Ёжңүй•ҝж—¶й—ҙеқҮзғӯеҢәзҡ„жӣІзәҝд»ҘеҮҸе°‘еҠ©з„ҠеүӮзҡ„еҮәж°”зҺҮпјӣи¶ҠиҝҮй”ЎиҶҸзҶ”еҢ–жё©еәҰж—¶дҪҝз”Ёйқһеёёзј“ж…ўеҚҮжё©йҖҹзҺҮзҡ„еӣһжөҒжӣІзәҝпјҢйҖӮеҪ“еўһеҠ йў„зғӯйҳ¶ж®өзҡ„дҝқжё©еҢәжё©еәҰпјҢе°Ҷе…¶ж—¶й—ҙ延й•ҝиҮіеҒҸдёҠйҷҗеҖјпјҢдҪҝдёӨз«Ҝзҡ„й”ЎиғҪеҗҢж—¶е……еҲҶзҶ”еҢ–гҖӮ
пјҲ5пјүжӯЈзЎ®и®ҫзҪ®йў„зғӯжңҹе·ҘиүәеҸӮж•°пјҢж №жҚ®жҜҸз§ҚдёҚеҗҢдә§е“Ғи°ғиҠӮеҘҪзӮүжё©йҖӮеҪ“зҡ„жё©еәҰжӣІзәҝгҖӮ
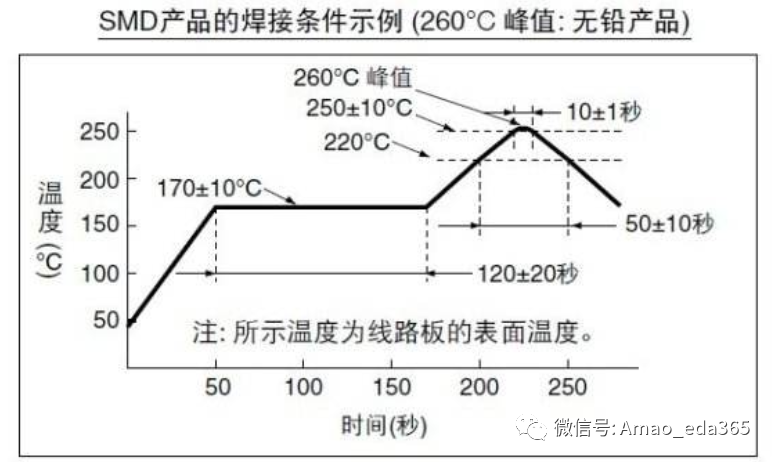
еӣҫ 6. иҝҮзӮүжё©еәҰжӣІзәҝ
5гҖҒе…ғ件з«ҜеӯҗйҮ‘еұһеұӮжҲ–PCBз„ҠзӣҳйҮ‘еұһеұӮзҡ„еҸҜз„ҠжҖ§дёҚдёҖиҮҙ
иҝҷжҳҜз”ұдәҺеҸ—еҲ°жұЎжҹ“жҲ–жҳҜж°§еҢ–пјҢжҳ“дәҺеңЁе…ғ件дёӨз«Ҝдә§з”ҹдёҚе№іиЎЎеҠӣпјҢеј•иө·з«Ӣзў‘гҖӮеҰӮжһңз„Ҡзӣҳж¶ӮеұӮжҳҜSn-Pbж¶ӮеұӮпјҢдёҖж—Ұз„Ҡж–ҷзҶ”еҢ–еңЁз„Ҡзӣҳд№ӢдёҠе°Ҷз«ӢеҚіж¶Ұж№ҝпјҢжүҖд»ҘпјҢе®ғеҜ№жЁӘиҝҮз„Ҡзӣҳзҡ„жё©еәҰжўҜеәҰжӣҙеҠ ж•Ҹж„ҹпјҢеҫҖеҫҖдјҡжҜ”жҷ®йҖҡзҡ„й“ңз„Ҡзӣҳдә§з”ҹжӣҙеҠ дёҘйҮҚзҡ„з«Ӣзў‘гҖӮ
гҖҗи§ЈеҶіж–№жЎҲгҖ‘
пјҲ1пјүеңЁй“ңз„ҠзӣҳдёҠдҪҝз”Ёжңүжңәзҡ„еҸҜз„ҠжҖ§дҝқжҠӨеүӮпјҲOSPпјүжҲ–й•Қ/йҮ‘пјҲNi/AuпјүжҲ–й”Ўж¶ӮеұӮд»ЈжӣҝSn-Pbж¶ӮеұӮгҖӮ
пјҲ2пјүеҮҸе°‘е…ғ件з«ҜеӯҗйҮ‘еұһ
пјҲ3пјүдҪҝз”Ёж°®ж°”зӮүпјҢеӣ дёәеңЁеҠ зғӯиҝҮзЁӢдёӯпјҢжңүж°®ж°”дҝқжҠӨдҪңз”ЁпјҢеӣ иҖҢе…¶йӣ¶д»¶и„ҡPCBз„ҠзӣҳпјҢеҸҜд»Ҙйҳ»жӯўй”ЎзІүйў—зІ’зӯүеҶҚеәҰж°§еҢ–зҡ„жғ…еҶөпјҢдҪҝе…¶з„Ҡй”ЎеҸҜеңЁж— еӨӘеӨҡж°§еҢ–зү©йҳ»жҢ дёӢеҝ«йҖҹз„ҠжҺҘгҖӮ
6гҖҒдёҚе№іиЎЎзҡ„ж¶Ұж№ҝ
дёҚе№іиЎЎзҡ„ж¶Ұж№ҝжҳҜз”ұдәҺдҪҝз”ЁдәҶж¶Ұж№ҝж—¶й—ҙеҝ«зҡ„еҠ©з„ҠеүӮпјҢжҲ–еҠ©з„ҠеүӮзҡ„жҝҖзғҲеҮәж°”пјҲиҝҷжҳҜз”ұдәҺдҪҝз”Ёй«ҳжҢҘеҸ‘жҖ§еҠ©з„ҠеүӮжҲ–еӣһжөҒж—¶иҝ…йҖҹеҠ зғӯеј•иө·пјүгҖӮ
гҖҗи§ЈеҶіж–№жЎҲгҖ‘
жҢ‘йҖүеҗҲйҖӮзҡ„еҠ©з„ҠеүӮгҖӮ
7гҖҒй”ЎиҶҸеҚ°еҲ·еҺҡеәҰ
иҫғй«ҳзҡ„й”ЎиҶҸеҚ°еҲ·еҺҡеәҰдә§з”ҹжӣҙеӨҡзҡ„з«Ӣзў‘пјҢдё»иҰҒжҳҜеӣ дёәе…ғ件еңЁеӨ§йҮҸзҡ„зҶ”иһҚз„Ҡж–ҷдёӯ“жјӮ移”гҖӮ
иҝҷдәӣдёҺй’ўзҪ‘зҡ„еҲ¶дҪңеҸҠеҠ е·Ҙз»ҶиҠӮзӣёе…іпјҢеҰӮпјҡ
пјҲ1пјүй’ўзҪ‘еӨӘеҺҡпјҢй”ЎиҶҸйҮҸеӨӘеӨҡ
пјҲ2пјүй’ўзҪ‘дёҺPCBй—ҙи·қиҝҮеӨ§
пјҲ3пјүеҚ°еҲ·жңәеҲ®еҲҖеҺӢеҠӣиҝҮе°Ҹ
пјҲ4пјүеӨҡж¬ЎеҚ°еҲ·й”ЎиҶҸ
пјҲ5пјүй”ЎиҶҸеқҚеЎҢпјҲзІҳеәҰдҪҺпјү
пјҲ6пјүй”ЎиҶҸеҚ°еҲ·еҒҸ移
пјҲ7пјү ……
гҖҗи§ЈеҶіж–№жЎҲгҖ‘
дҪҝз”Ёиҫғи–„зҡ„й”ЎиҶҸеҚ°еҲ·еҺҡеәҰгҖӮ
еңЁе…·дҪ“з”ҹдә§ж—¶еҲҷйңҖиҰҒжіЁж„ҸдёӢйқўзҡ„иҝҷдәӣжғ…еҶөпјҡ
пјҲ1пјүи°ғж•ҙй”ЎиҶҸеҚ°еҲ·жңәеҸӮж•°
пјҲ2пјүи°ғж•ҙй”ЎиҶҸеҚ°еҲ·жңәеҲ®еҲҖеҺӢеҠӣ
пјҲ3пјүеҸӘеҚ°еҲ·дёҖж¬Ўй”ЎиҶҸ
пјҲ4пјүзј©зҹӯй”ЎиҶҸеҚ°еҲ·еҗҺж”ҫзҪ®ж—¶й—ҙпјҲи°ғж•ҙй”ЎиҶҸзІҳеәҰпјү
пјҲ5пјүи°ғж•ҙй”ЎиҶҸеҚ°еҲ·жңәеҸӮж•°
пјҲ6пјүи°ғж•ҙиҙҙзүҮжңәеә§ж Ү
пјҲ7пјүи°ғж•ҙеӣһжөҒзӮүи®ҫзҪ®
8гҖҒе…ғеҷЁд»¶иҙҙж”ҫзІҫеәҰ
дёҖдәӣжңәеҷЁеңЁиҙҙж”ҫе…ғеҷЁд»¶ж—¶зІҫеәҰеӨӘе·®пјҢдјҡзӣҙжҺҘеҜјиҮҙзүҮејҸе…ғ件дёӨз«Ҝж¶Ұж№ҝзҡ„дёҚе№іиЎЎпјҢеҠ йҮҚдәҶз«Ӣзў‘зҺ°иұЎгҖӮ
гҖҗи§ЈеҶіж–№жЎҲгҖ‘
жҸҗй«ҳе…ғ件иҙҙж”ҫзІҫеәҰгҖӮ
еҜ№дәҺ硬件件е·ҘзЁӢеёҲжҲ–PCBи®ҫи®Ўе·ҘзЁӢеёҲпјҢеҰӮжІЎжңүеҲӣе»әPCBе°ҒиЈ…еә“зҡ„з»ҸйӘҢдҪҶе·ҘдҪңдёҠйңҖиҰҒиҮӘиЎҢеҲӣе»әPCBеә“ж—¶пјҢеҸҜд»ҘжҢүгҖҠPCBе°ҒиЈ…дёҺеҺҹзҗҶеӣҫеә“е·ҘзЁӢи®ҫи®ЎгҖӢдёӯзҡ„е»әеә“жӯҘйӘӨеҸҠж–№жі•пјҢ并еҸӮиҖғд№ҰдёӯжҸҗдҫӣзҡ„дёҚеҗҢе°әеҜёз„ҠзӣҳиЎҘеҒҝзҡ„ж•°жҚ®пјҢеҹәжң¬еҸҜд»ҘеҲӣе»әеҮәжӯЈзЎ®зҡ„PCBе°ҒиЈ…еә“гҖӮ
ж–Үз« жқҘжәҗпјҡеҫ®дҝЎ